算力带动 HBM 需求井喷,HBM 持续迭代升级。与 DDR 对比,HBM 基于 TSV 工艺与处理器封装于同一中介层,在带宽、面积、功耗等多方面更具优势,缓解了数据中心能耗压力及带宽瓶颈。训练、推理环节存力需求持续增长、消费端及边缘侧算力增长打开 HBM 市场空间。2022 年全球 HBM 市场规模约为36.3 亿美元,预计至 2026 年市场规模将达 127.4 亿美元,CAGR 达 37%。HBM 持续迭代升级,2023 年主流 HBM 从 HBM2E 升级为 HBM3 甚至 HBM3E,HBM3比重预估约为 39%,2024 年提升至 60%。当前 HBM 市场仍由三大家主导,2022 年全年 SK 海力士占 50%,三星占 40%,美光占 10%。


TSV 为 HBM 核心工艺,电镀、测试、键合需求提升。TSV 为 HBM 核心工艺,成本占比接近 30%,是 HBM 3D 封装中成本占比最高的部分。TSV 通孔填充对性能至关重要,铜为主流填充材料。TSV 成本结构中通孔填充占比 25%,驱动电镀市场规模增长。TECHCET 预计 2022 年先进封装和高端互联应用中,电镀材料全球市场规模近 10 亿美元,到 2026 年预计超过 12 亿美元。HBM需要进行 KGSD(Known Good Stacked Die)测试,拉动测试需求。HBM 高带宽特征拉动键合需求,从 μbump 到 TCB/混合键合,推动固晶步骤和固晶机单价提升。

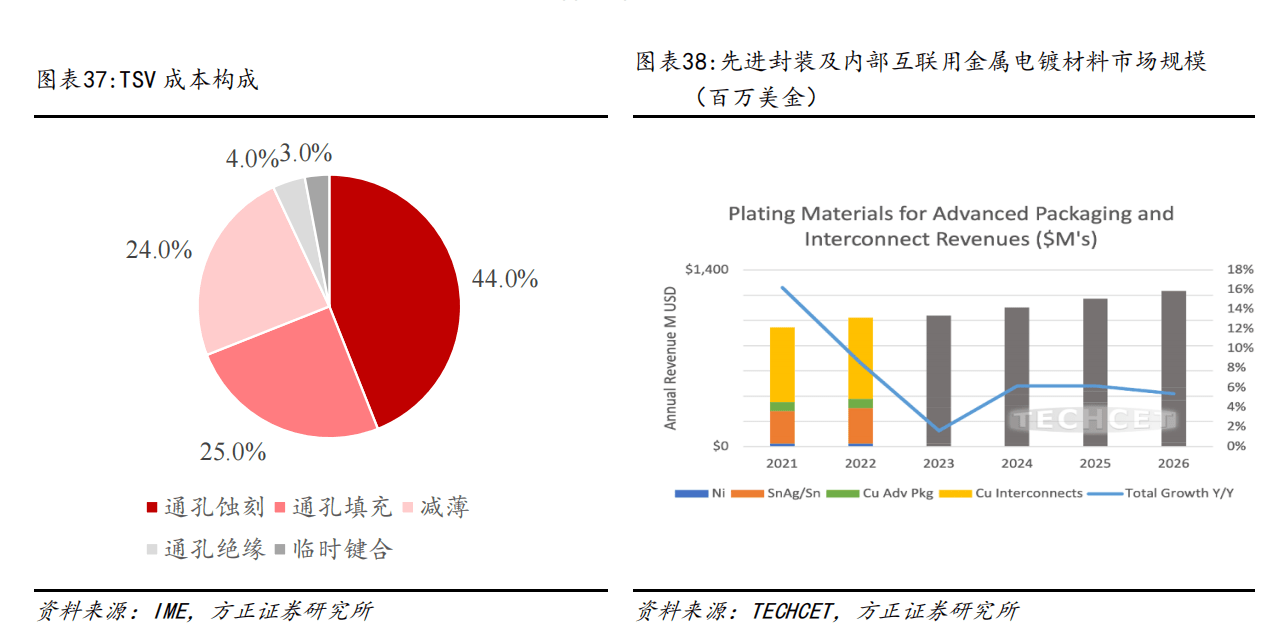
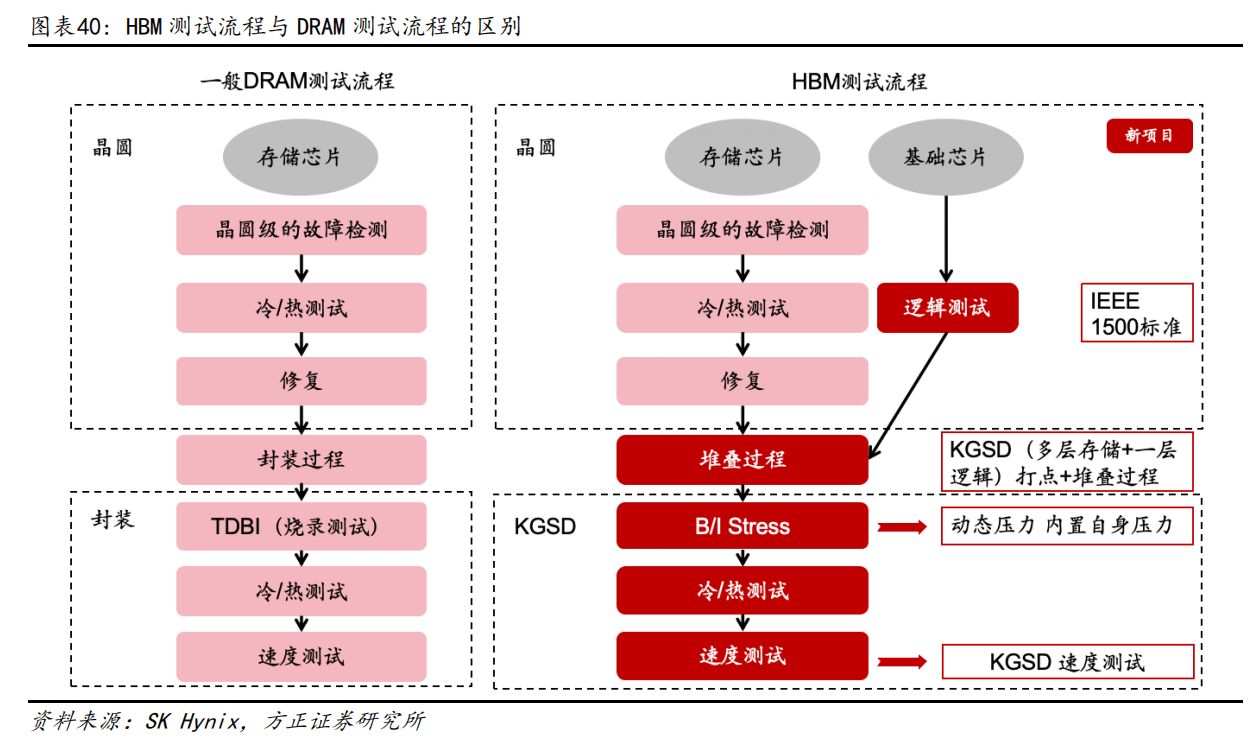
SK 海力士技术领先,三星/美光加速追赶。1)SK 海力士:技术领先,核心在于 MR-MUF 技术,MR-MUF 能有效提高导热率,并改善工艺速度和良率。SK海力士于 2021 年 10 月率先发布 HBM3,2023 年 4 月公司实现了全球首创 12层硅通孔技术垂直堆叠芯片,容量达到 24GB,比上一代 HBM3 高出 50%,SK海力士计划在 2023 年年底前提供 HBM3E 样品,并于 2024 年量产,公司目标 2026 年生产 HBM4;2)三星:万亿韩元新建封装线,预计 25 年量产 HBM4。 为应对 HBM 市场的需求,三星电子已从三星显示(Samsung Display)购买天安厂区内部分建筑物和设备,用于建设新HBM封装线,总投资额达到7000-10000 亿韩元。三星预计将在 2023Q4 开始向北美客户供应 HBM3;3)美光:
2024 年量产 HBM3E,多代产品研发中。美光在此前的财报电话会议上表示将在 2024 年通过 HBM3E 实现追赶,预计其 HBM3E 将于 2024Q3 或者 Q4 开始为英伟达的下一代 GPU 供应。11 月 6 日美光在台湾台中四厂正式开工,宣布将集成先进的探测和封装测试功能,生产 HBM3E 等产品。
国内产业链有望在各品类半导体设备、材料受益。1)固晶机:新益昌;2)测试机、分选机等:长川科技;3)特种气体:华特气体;4)电子大宗气体:金宏气体、广钢气体;6)前驱体:雅克科技;7)电镀液:天承科技;8)环氧塑封料:华海诚科。
文章来源:方正证券、郑震湘;执业编号:S1220523080004
*免责声明:文章内容仅供参考,不构成投资建议
*风险提示:股市有风险,入市需谨慎